
扫码加微信

热门关键词:展至科技 氧化铝陶瓷基板/支架 氮化铝陶瓷基板/支架 陶瓷覆铜板 陶瓷电路板
在电子封装过程中,陶瓷基板主要起到机械支撑保护和电气互连(绝缘)的作用。随着电子封装技术不断向小型化、高密度、多功能、高可靠性的方向发展,电子系统的功率密度越来越大,散热问题也越来越严重。影响器件散热的因素很多,其中dpc陶瓷基板材料的选择也是一个关键环节。
目前,电子封装中常用的陶瓷基板材料主要有四种:聚合物基板、金属基材、复合基板、陶瓷基板。dpc陶瓷基板材料以其强度高、绝缘性好、导热耐热性好、热膨胀系数小、化学稳定性好等优点被广泛应用于电子封装基板。

dpc陶瓷基板封装材料主要有氧化铝、氧化铍和氮化铝。氧化铝陶瓷是目前最成熟的陶瓷基板封装材料,以其良好的抗热震性和电绝缘性以及成熟的制造加工工艺而被广泛应用。
美国、日本等国家已研制出多层陶瓷基板,使其成为一种应用广泛的高科技陶瓷。目前使用的陶瓷基板材料有氧化铝、氧化铍、氮化铝、碳化硅、莫来石等。
dpc陶瓷基板按结构和制造工艺可分为高温共烧多层陶瓷基板、低温共烧陶瓷基板、厚膜陶瓷基板等。
高温共烧陶瓷(HTCC)
先将陶瓷粉(氮化硅粉、氧化铝粉、氮化铝粉)加入有机粘结剂中,搅拌均匀成糊状;然后用刮刀将浆料刮成片状,经干燥过程形成生浆;然后按照每一层的设计打通孔,用丝印金属膏进行布线和填孔;最后将绿色层覆盖并在高温炉(1600℃)进行烧结。
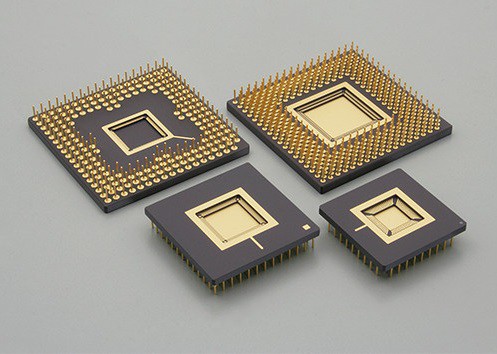
由于烧结温度高,金属导体材料的选择受到限制(主要是钨、钼、锰等熔点高但导电性差的金属)。高温共烧陶瓷基板的生产成本较高,其导热系数一般在20~200W/(m•℃)取决于陶瓷粉末的成分和纯度。
低温共烧陶瓷(LTCC)
低温共烧陶瓷基板的制备工艺与高温共烧多层陶瓷基板的制备工艺相似。不同之处在于低温共烧陶瓷基板在氧化铝粉中掺入质量分数为30%~30%的低熔点玻璃材料,将烧结温度降低到850~900℃。因此,具有良好导电性的金和银可用作电极和布线材料。
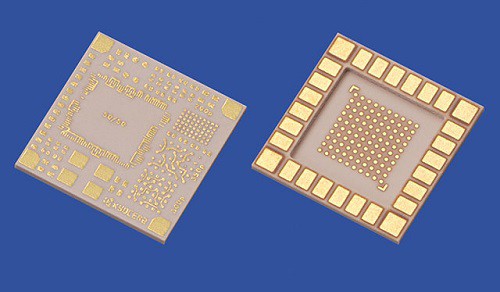
但另一方面,由于陶瓷材料中含有低温共烧陶瓷基板玻璃相,复合热导率仅为2~3w/(m•℃)。此外,由于低温共烧陶瓷基板采用丝网印刷技术制作金属电路,因此可能会因网线问题而导致对位误差;此外,多层陶瓷叠层烧结的收缩率不同,影响成品率。
在实际生产中,可以在贴片区域增加导热或导电孔,以提高低温共烧陶瓷基板的导热性,但缺点成本会增加,为了扩大dpc陶瓷基板的应用领域,一般采用多层层压和共烧技术生产具有腔体的多层结构,满足电子器件气密封装的要求,广泛应用于具有空腔的领域。航空航天鞥恶劣环境和光通信等高可靠性要求。
厚膜陶瓷基板
与高温共烧多层陶瓷基板和低温共烧陶瓷基板相比,厚膜陶瓷基板是一种后烧陶瓷基板。制备工艺是先用丝网印刷技术将金属浆料涂敷在陶瓷基板表面,经干燥、高温烧结(700~800℃)即可制备。
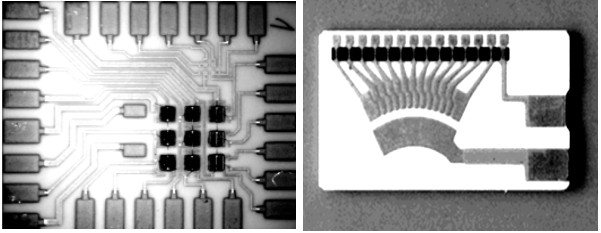
金属浆料一般由金属粉末、有机树脂和玻璃粉末组成。烧结金属层的厚度为10~20μm,最小线宽为0.3mm。由于技术成熟、工艺简单、成本低廉,厚膜陶瓷基板已应用于对图形精度要求不高的电子封装中。
