
扫码加微信

热门关键词:展至科技 氧化铝陶瓷基板/支架 氮化铝陶瓷基板/支架 陶瓷覆铜板 陶瓷电路板
陶瓷和金属是最古老的两类有用材料,陶瓷材料具有耐高温、高强度、高硬度、耐磨损、耐腐蚀、电绝缘强度高等特性,而金属材料具有优良的延展性、导电性、导热性,它们各自的广泛用途在这里就不多赘述了。那么,将陶瓷材料与金属材料结合起来,就能在性能上形成优势互补。
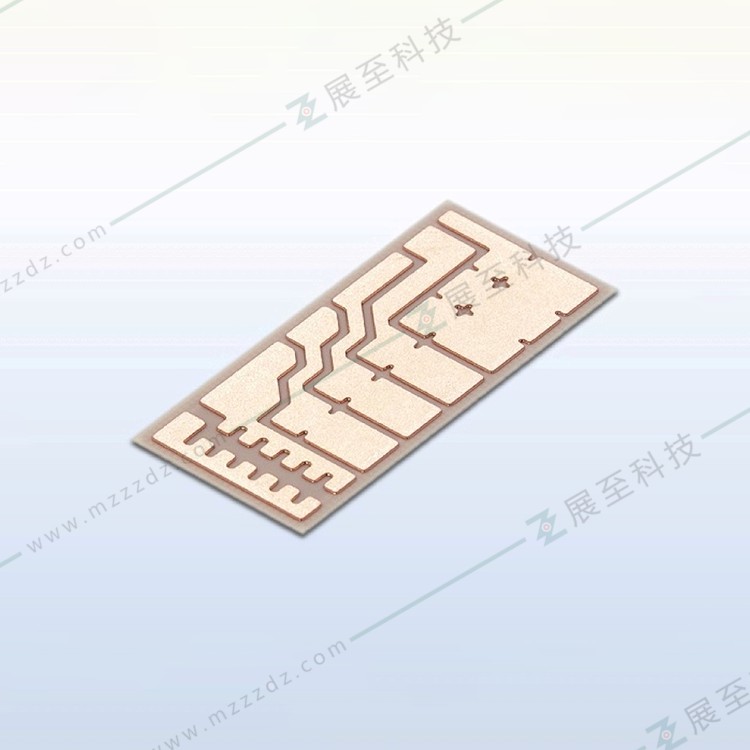
陶瓷金属化是在陶瓷表面牢固地粘附一层金属薄膜,使之实现陶瓷和金属间的焊接,现有钼锰法、镀金法、镀铜法、镀锡法、镀镍法、LAP法(激光后金属镀)等多种陶瓷金属化工艺。
陶瓷金属化产品的陶瓷材料有:96白色氧化铝陶瓷、93黑色氧化铝陶瓷、氮化铝陶瓷、氮化硅陶瓷等。由于陶瓷材料表面结构与金属材料表面结构不同,焊接往往不能润湿陶瓷表面,也不能与之作用而形成牢固的黏结,因而陶瓷与金属的封接是一种特殊的工艺方法,即金属化的方法:先在陶瓷表面牢固的黏附一层金属薄膜,从而实现陶瓷与金属的焊接。另外,用特制的玻璃焊料可直接实现陶瓷与金属的焊接。
陶瓷与金属的连接件在新能源汽车、电子电气、半导体封装和IGBT模块等领域有着广泛的应用,因此,具有高强度、高气密性的陶瓷与金属的封接工艺至关重要。目前常用的陶瓷及其表面金属化:
1.BeO陶瓷
BeO陶瓷最经常使用的金属化方式是钼锰法。该方法是将纯金属粉末(Mo、Mn)与金属氧化物组成的膏状混合物涂于陶瓷表面,再在炉中高温加热,形成金属层。在Mo粉中加入10%~25% Mn是为了改善金属镀层与陶瓷的结合。
2.Al2O3陶瓷
Al2O3陶瓷最主要的金属化方法是直接敷铜法(Direct Bonded Copper method,DBC),其主要特点是在金属化过程中,不需要额外加入其他物质即可实现铜箔和Al2O3陶瓷的直接连接。过程如下:首先将处理完毕的铜箔覆盖在Al2O3陶瓷表面,通入一定含氧量的惰性气体,然后进行升温,在此过程中铜表面会被氧化,当温度到达共晶液相存在区间后,Al2O3陶瓷和铜彼此间就会产生共晶液相,该液相同时润湿Al2O3陶瓷和铜,完成初步的连接,随后在冷却的过程中,共晶液相析出Cu和Cu2O,存在于连接界面处,实现紧密的连接。
3.AlN陶瓷
目前使用的方法主要是直接敷铜法(DBC)和活性金属化钎焊法(Active Metal Brazing,AMB)。
AlN陶瓷的直接覆铜法与Al2O3陶瓷类似,但又有所不同。这是由于AlN是非氧化物陶瓷,共晶液相在它表面的铺展效果很差,无法直接进行键合,需要将其在1200 ℃左右进行预氧化处理,氧化完成后,在AlN陶瓷表面会生成约1-2 μm的氧化铝层。将预氧化后的AlN陶瓷和铜在共晶液相存在的温度区间进行连接,完成AlN覆铜板的制备。
另一种常用的方式是AMB,是通过活性金属钎料将AlN陶瓷和铜箔进行连接,最常用的金属钎料为 Ag-Cu-Ti体系。金属钎料中Ti为活性金属,在钎料中的质量占比约为1-5%,Cu的质量占比约为28%,Ag的质量占比约为67-71%。通过活性金属钎焊的方式实现AlN陶瓷和铜箔之间的连接,存在的问题是形成的结构内部会留下较多的内应力,在实际应用过程中容易存在可靠性问题。因此,在金属钎料成分设计过程中,除了Ag、Cu、Ti金属颗粒之外,还需要添加一些可以降低热失配的填充物。目前,常用作填充物的物质主要包括SiC、Mo、TiN、Si3N4、Al2O3等。
4.Si3N4陶瓷
Si3N4陶瓷的表面金属化不能使用直接覆铜法的原因是Si3N4陶瓷无法像AlN陶瓷一样,直接在陶瓷表面生成氧化层。Si3N4陶瓷一般的通过活性金属钎焊(AMB)的方式将Si3N4陶瓷和铜进行连接的。与AlN一样,Si3N4也是一种氮化物,可以和一些活性金属(Ti、Cr、V)发生化学反应,在界面层生成连续的氮化物,从而实现Si3N4陶瓷和金属钎料之间的连接。最常用的金属钎料是 Ag-Cu-Ti 体系,但这些钎料的液相线低于1200 K,钎料的抗氧化性能很差,钎焊连接后的使用温度不宜高于755 K。
陶瓷金属化的应用
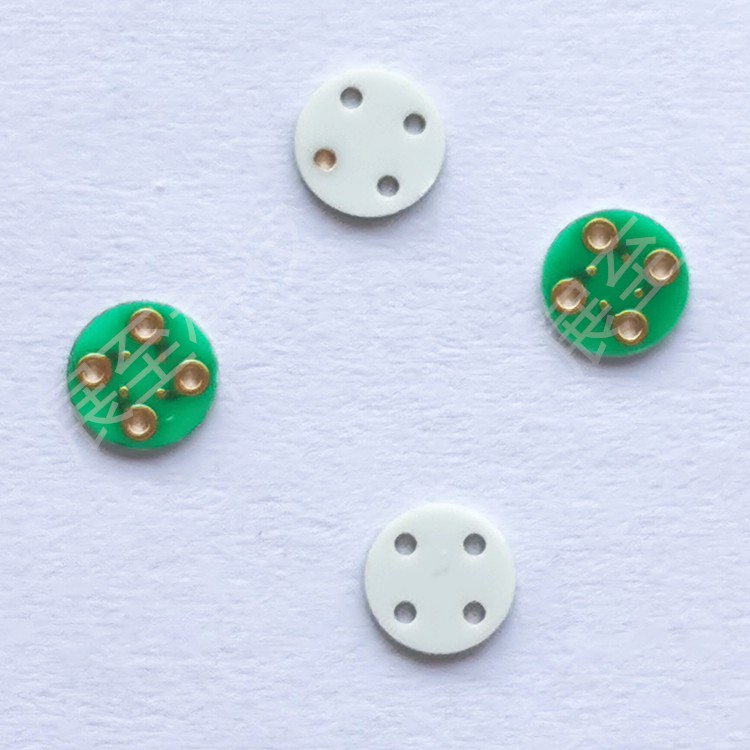
1.电力电子领域 真空开关管(陶瓷真空灭弧室)是氧化铝陶瓷经金属化后与铜封接成一体,是一种新型高性能中高压电力开关的核心部件,其主要作用是,通过管内真空优良的绝缘性使中高压电路切断电源后能迅速熄弧并抑制电流,从而达到安全开断电路和控制电网的作用,避免事故和意外的发生。
2.微波射频与微波通讯 在射频/微波领域,氮化铝陶瓷基板具有其它基板所不具备的优势:介电常数小且介电损耗低、绝缘且耐腐蚀、可进行高密度组装。其覆铜基板可应用于射频衰减器、功率负载、工分器、耦合器等无源器件、通信基站(5G)、光通信用热沉、高功率无线通讯、芯片电阻等领域。
3.LED封装 对于现有的LED光效水平而言,由于输入电能的80-85%左右转变成热量,且LED芯片面积小,工作电流大,造成芯片工作的温度高,因此芯片散热是LED封装必须解决的关键问题。
4.IGBT领域 绝缘栅双极晶体管(简称IGBT)以输入阻抗高、开关速度快、通态电压低、阻断电压高、承受电流大等特点,成为当今功率半导体器件发展主流。
信息来源:
(以上信息来源或部分来源于以下文献或网络链接,若有侵权请及时告知以便删除)
