
扫码加微信

热门关键词:展至科技 氧化铝陶瓷基板/支架 氮化铝陶瓷基板/支架 陶瓷覆铜板 陶瓷电路板
针对要求最严苛的功率开关应用的功率分立元件和模块的封装趋势,从而引入改进的半导体器件。即碳化硅(SiC)和氮化镓(GaN)等宽带隙类型,将显着提高功率开关应用的性能,尤其是汽车牵引逆变器等应用中。
在需要低损耗、高频开关或高温环境的功率应用中,碳化硅陶瓷基板功率半导体技术与传统硅基器件相比具有显着优势。例如,Sic的介电强度电压大约是硅的10倍,低损耗对性能比至关重要,而SiC技术可将功率损耗降低多达五分之一。
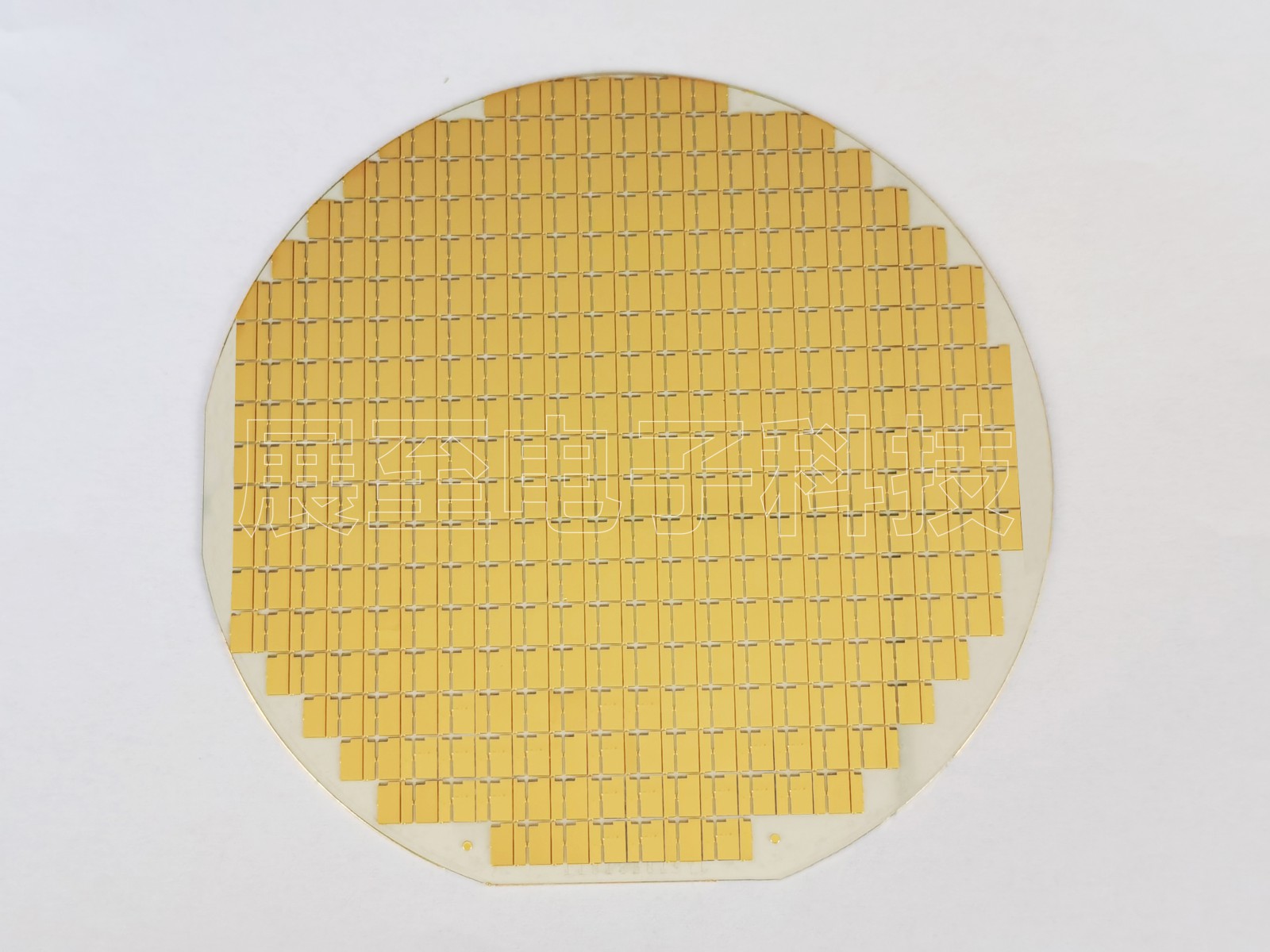
这些技术的一些优势已经得到证明和部署,特别是碳化硅在独立充电站应用(高压),以及最近在牵引逆变器组件(高温、高开关频率)中的应用,成为真正在汽车电气化领域。凭借大幅提高性能的潜力,该行业仍然要面临挑战,可以部署哪些新的封装创新来实现这些有前途的半导体器件的全部性能优势?
在改进功率模块封装设计的第一步,甚至在碳化硅出现之前就涉及在陶瓷基板上使用直接键合铜,例如氧化铝和氮化铝以取代用纯铜制成的基板。这些陶瓷基板表现出显着较低的热膨胀系数(CTE)特性,同时仍提供合理的导热性。
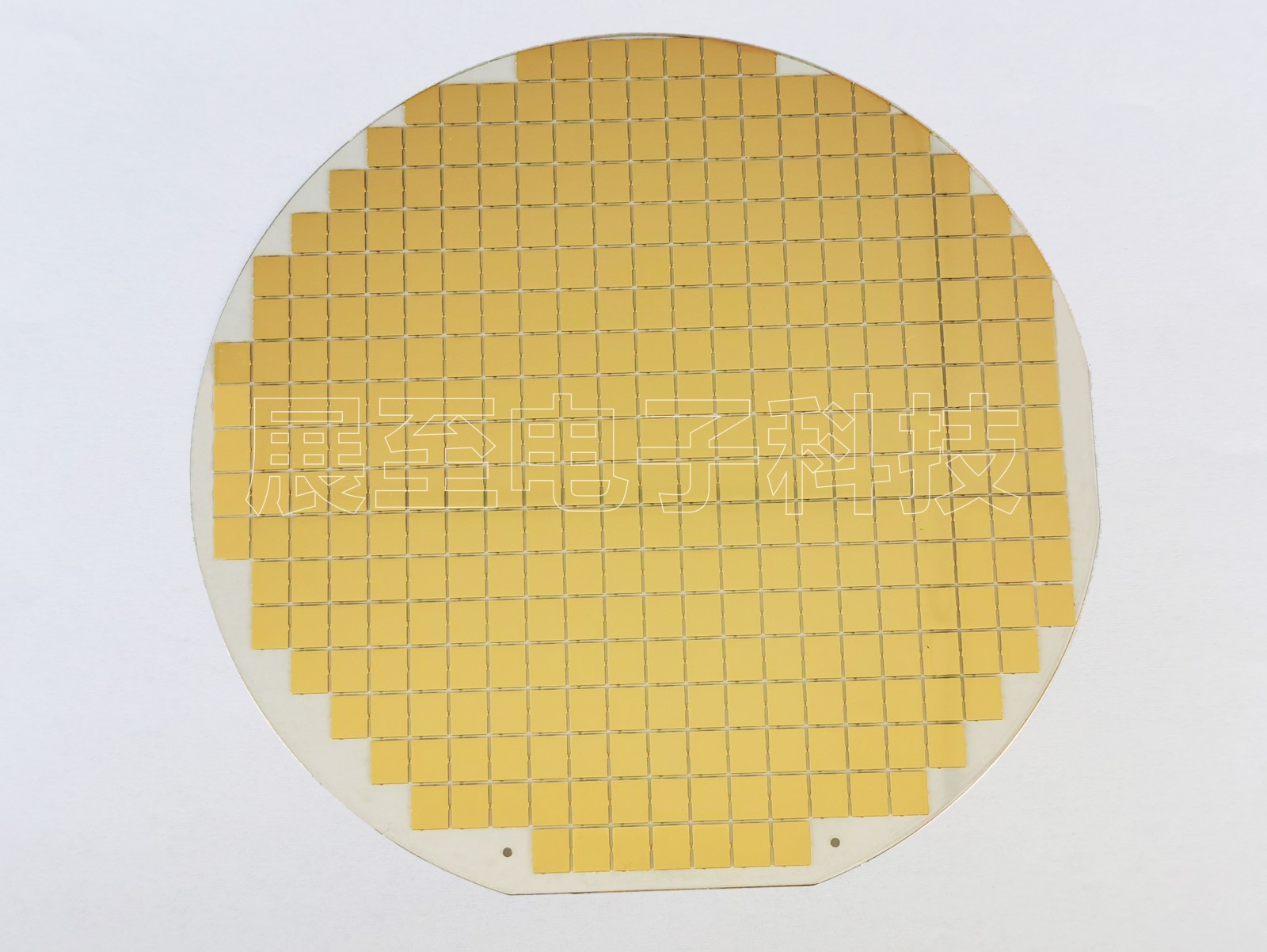
如图1a和1b所示,可以通过调整铜的厚度相对于内核氧化铝的厚度来修改CTE。例如达到7-9ppm/摄氏度,这为安装提供了更好的匹配低CTE半导体模具。通过这样做总的CTE失配(芯片与基板)现在为3-7ppm,而不是安装到铜引线框架的半导体芯片的情况下的13-15ppm,直接键合铜DBC陶瓷基板在当今的多芯片电源模块系统中非常普遍,但也有选择性地使用铜引线框,尤其是单芯片器件。
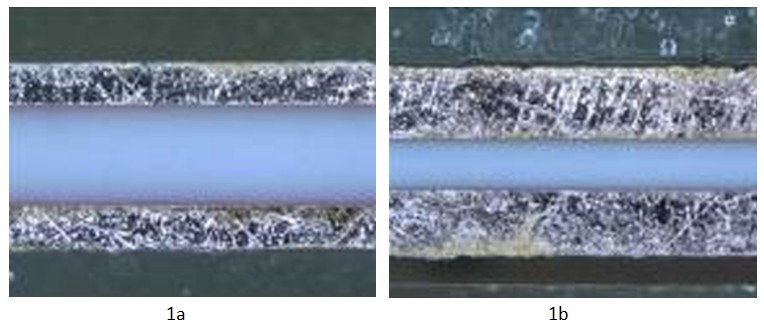
另一个最近的发展是使用铜作为陶瓷上的金属化,与铜金属化相比,它们的热循环性能有所提高。如图2所示,陶瓷基板顶部金属化被蚀刻以形成物理电路,该电路可以接受芯片连接,然后是顶部引线键合。而基板表面处理也很常见,它可以在通常包括回流焊的芯片贴装工艺之前提供强大的表面保护,典型的焊料包括使用高铅用于芯片连接,以及用于基板底部连接到模块散热器的较低熔点焊料。
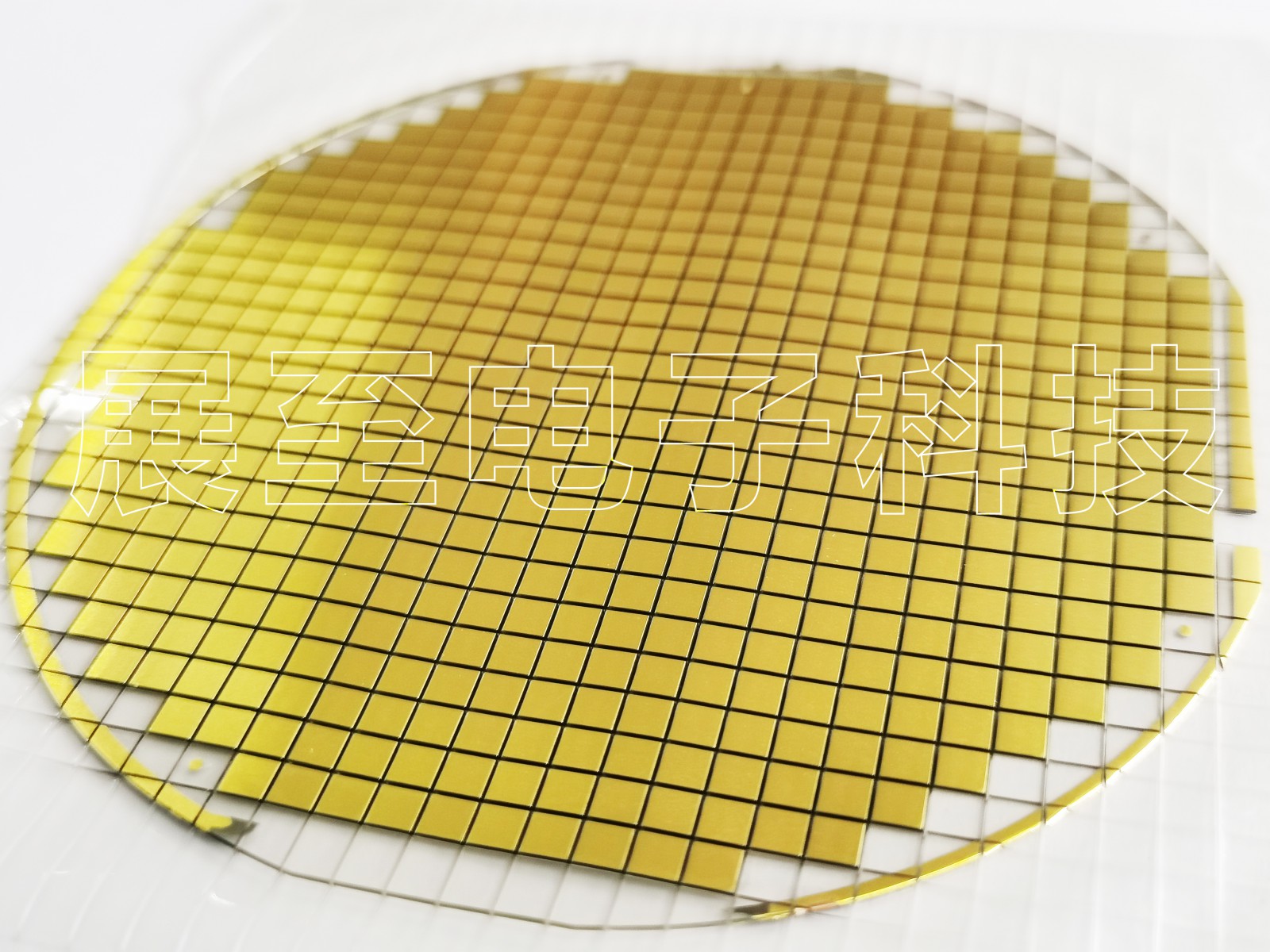
以类似的方式,单管芯片或双管芯片封装(例如IGBT二极管)对使用重型铜引线框和用于电源连接和控制的顶部焊线。如图3所示,铅焊线可以用铜夹代替,以改善芯片冷却。这种配置还提供改进的热循环性能。与单芯片封装一样,用更稳健的顶部连接取代铝焊线的模块实现了额外的芯片冷却、更大的电流密度和改进的功率循环。15多年前就提出了IGBT二极管模块的双面冷却,并已在混合动力电动汽车使用的许多汽车牵引逆变器组件中得到部署。

在基于DBC氧化铝和氮化铝的模块中,顶部连接也使用相同的材料实现。根据顶侧芯片接触面积,典型的实施可以使模块的热阻降低30%。双面冷却模块可能需要能够为非功率导向焊线提供间隙的功能,例如小型栅极和电流感应焊盘。在这些情况下,当需要确保在较高电压应用中基板之间的气隙最小时会使用间隔物。垫片可以由导热和导电材料制成例如铜,但由于传统硅的芯片尺寸可能非常大12mm x 12mm当使用仅与相对较薄的铜和管芯表面之间的焊接粘合层。在这里间隔件的可行替代解决方案包括复合材料,例如铜-钼和层压板,例如铜-殷钢-铜或铜-钼-铜。
为确保足够的功率循环性能和焊接连接的寿命,电流负载分布在多个管芯上,从而降低每个管芯的电流密度。虽然这种方式需要更多设备来实现给定功能,但需要降额以确保稳健的安装产品寿命。
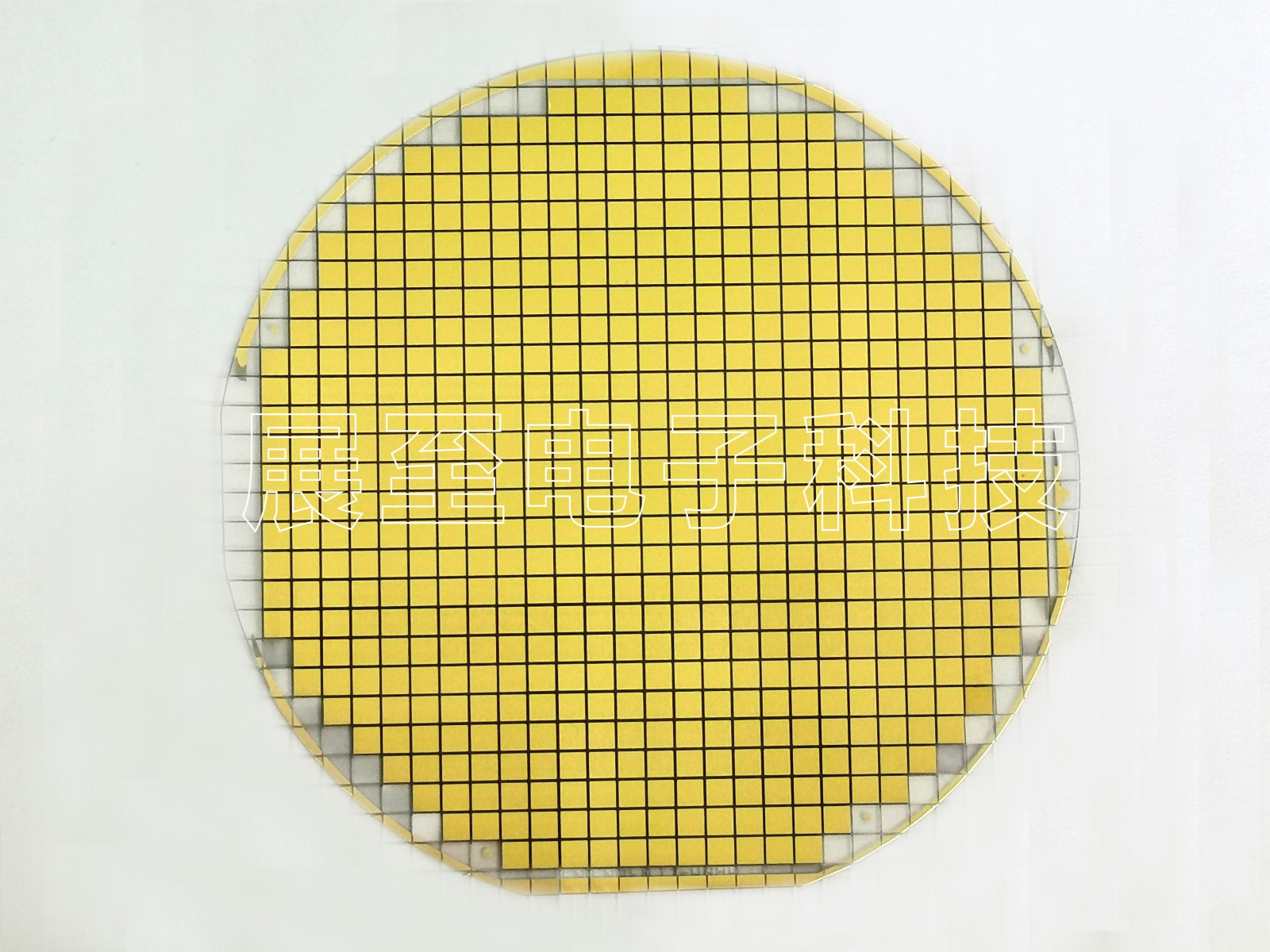
随着行业向碳化硅等宽带隙器件过渡,这些器件的封装将成为影响新模块可靠性、性能和成本的关键因素。SiC在较高的工作温度下效率更高,理想的封装设计应支持这一事实,以提高芯片效率。与硅和SiC一起部署的最有前途的附着材料之一是烧结银。 如图1所示,银是一种近乎理想的附件材料,但其熔点使其无法用作回流金属。尽管如此,它具有非常高的导热性,并表现出极具吸引力的低电阻率。所有这些特性都优于焊接,包括功率循环能力,这将在后面讨论。
随着不同类型的烧结银大批量生产应用的增加,材料类型也在增加。虽然最初的烧结银应用依赖于银纳米浆料,但薄膜和预成型件已成为可行的产品类型,从而实现了新的制造工艺。晶圆级层压现在可以用纳米银膜实现。一旦晶圆被层压,就可以使用标准设备对晶圆进行切割。还开发了一种替代工艺,可以层压晶圆上的单个芯片,然后立即将它们烧结在目标基板上。这被称为模具转移膜工艺。优点是只层压和烧结已知好的芯片与SiC一起使用时可以提供显着的优势。
